오픈 Ai 챗 GPT로 시작된 인공지능 시대에서 CPU보다 GPU(그래픽 처리 장치 )가 더욱 크게 주목을 받습니다. 직렬 연산인 CPU 보다 병렬 연산인 GPU가 동일한 시간 내에 더 많은 연산을 처리할 수 있기 때문인데요 AI에 사용하는 GPU는 한 번에 처리하는 연산 양도 커져야 하며 따라서 대역폭과 용량이 커지고 집적도도 높아야 되는 상황에서 HBM은 인공지능 시대에서는 필수 요소도 부각이 되고 있는 상황입니다. TSV를 알기 위해선 HBM의 개념도 이해하는 것이 좋습니다. HBM에 대해 알아보도록 하겠습니다.
HBM (high band width memory) ?
HBM은 High Bandwidth Memory의 약자로, 고밀도와 높은 대역폭을 가진 혁신적인 고 대역폭 메모리입니다. 기존의 DDR 혹은 GDDR 메모리와는 다른 방식으로 작동하여 데이터 처리 속도를 대폭 향상시킵니다.
아래 글은 미국주식 인공지능 관련 주식 공부하기에 관한 내용입니다.
https://isanghanyoutube.com/미국-ai-관련주-인공지능-미국주식-공부하기/(새탭에서 열기)
HBM?
HBM은 주로 그래픽 카드와 같이 대량의 데이터를 신속하게 처리해야 하는 기기에서 사용됩니다. HBM은 sk하이닉스에서 지난 2008년 미국 AMD와 공동 개발로 세계 최초로 개발에 성공했었고 1세대 HDM 개발 이후 2022년에는 4세대 HBM3가 중점적으로 생산이 이루어지고 있는 상황입니다. 4세대 HBM3는 세계 최초로 12단으로 적층 한 24GB 신제품의 개발도 성공한 상태입니다.
인공지능 기술이 발전할수록 서버에서 원활한 서비스를 지원하기 위해서는 GPU(그래픽처리장치)와 더불어 HBM 필수적으로 적용돼야 하는 상황이기 때문에 중장기적으로 수요는 폭발적으로 증가할 것으로 예상하고 있습니다.
SK하이닉스는 엔비디아에 HBM3를 독점 공급하고 있습니다. 삼성에 이에 뒤질세라 지난달 스노우 볼트라는 상표를 출원했으며 하반기 출시 예정인 HBM3P의 브랜드가 될 예정입니다. 아쿠아 볼트 (HBM2) 플래시 볼트 (HBM2E) 아이스 볼트 (HBM3) 로 이어지는 시리즈별 제품명을 붙이고 있습니다.

HBM 작동 원리
HBM은 3D 스택 통합 기술을 사용하여 여러 개의 메모리 칩을 한 패키지 안에 적층 시킵니다. 이는 데이터 전달 경로를 짧게 유지하면서 대역폭을 크게 늘리는 데 도움이 됩니다. 각 메모리 칩은 높은 속도로 데이터를 주고받을 수 있는 인터페이스를 가지고 있으며, 이 인터페이스는 데이터 전송 속도를 높이는 역할을 합니다.
HBM의 주요 장점
HBM은 여러 가지 장점을 가지고 있습니다. 첫째로, 높은 대역폭을 제공하여 대량의 데이터를 신속하게 처리할 수 있습니다. 둘째로, 작은 공간에 많은 용량을 제공하기 때문에 기기의 크기를 작게 유지할 수 있습니다. 세째로, 낮은 전력 소비로 효율적인 에너지 관리가 가능하며, 이는 환경 친화적인 기술을 지향하는 현대 사회에 큰 이점을 제공합니다.
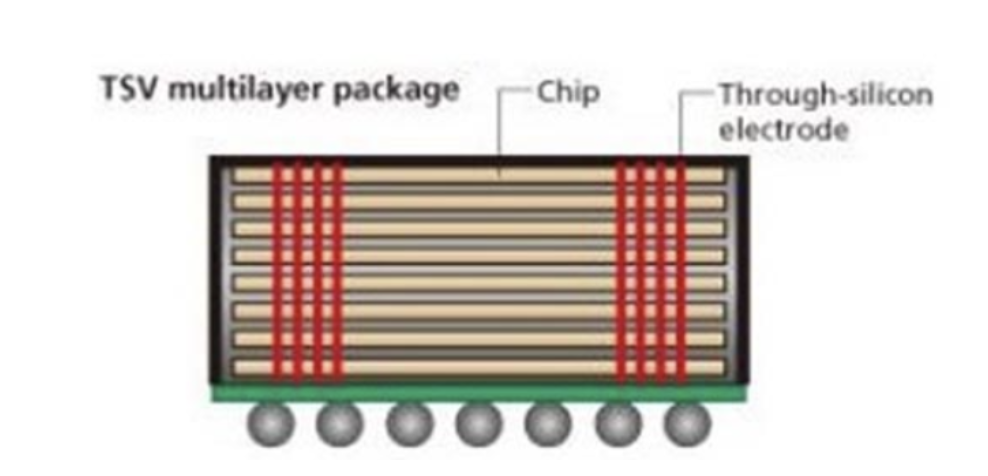
하반기 유망 산업 알아보기 클릭시 이동
TSV?
TSV (through Sliicon Vlia) 약자를 사용하며 실리콘 관통전극을 의미합니다. 예전에는 와이어 본딩 작업으로 칩을 척층했었따고 한다면 TSV는 칩에 미세한 구멍을 뚫어 작업하고 상단 하단의 칩을 전기적 작업을 통해 연겨라는 패키징을 의미합니다. 데이터를 예전보다 빠르게 하고 전력 소모 또한 저전력으로 패키지 크기도 더 작게 해주어 원가 절감에도 도움이 됩니다.

TSV(Trough-Silicon Via)에 대해 자세히 설명드리겠습니다.
TSV는 기본적으로 수직 연결을 위한 구조로, 한 반도체 칩의 상단부터 하단까지 이어주는 역할을 합니다. 이를 통해 칩 간의 거리를 크게 줄여 데이터 전송 속도를 향상시키고, 전력 소비를 줄일 수 있습니다.
TSV 기술은 반도체 패키징 분야에서 중요한 역할을 하는데, 특히 3D IC(3차원 집적회로)에서 핵심적인 역할을 합니다. 3D IC는 여러 개의 반도체 칩을 수직으로 쌓아 데이터 전송 속도를 높이고, 전력 소비와 칩의 크기를 줄이는 기술입니다. 이런 3D IC를 구현하기 위해서는 반드시 TSV 기술이 필요하며, 이로 인해 TSV는 반도체 산업에서 핵심적인 요소로 인식되고 있습니다.
하지만 TSV 기술은 제조 과정이 복잡하고 비용이 많이 드는게 현재 상황입니다. 다만, 미래의 고성능 반도체에는 필수적인 기술로 여겨져 연구와 개발이 활발히 진행되고 있습니다.
AI 인공지능 기술이 발전하고 시장이 커질수록 HBM 시장성도 폭발적으로 커질것으라는 전망이 높습니다. 가트너의 시장 조사 결과에 따르면 AI 반도체 시장은 20년도 약 30조 규모였다가 25년에는 92조 이상으로 성장할 것으로 예상하며 연평균 45%의 폭발적 성장을 내다보고 있습니다.
TSV 관련주?
프로텍 (053610)
1997년 설립 이후 반도체 후공정 장비를 제조하는 업체로 최근 한국기계연구원과 프로텍이 공동으로 GANG-Bonder 장비라 개발 반도체 후공정의 생산성을 100배 이사 높여주는 장비라는 설명입니다.
갱본더 기술이란 기존 반도체 칩을 기팡에 하나씩 조립하던 기존 방식과 달리 여러 개 칩을 동시에 조립하는 기술도 낮은 온도로 일차적 칩을 간소하게 조립한 후 다시 대략의 칩을 일괄로 전기 접속하는 방식을 말합니다.
한미반도체 ( 042700 )
sk하이닉스의 긴밀한 협력사이며 반도체 후공정 장비를 제작하는 업체로 열 압착 본딩 장비 TSV tc Bonder를 판매중으로 HBM3의 직접적인 수혜 장비이며 챗 GPT의 수혜주가 될 수 있습니다.

코미코
반도체 장비 부품 세정 코팅 전문 기업으로 국내 시장 점유율 1위의 기업이며 반도체 장비회사들의 원가절감 필요성이 대두 될수록 기업가치가 올라가고 수요 증가 매출이 확대될 것으로 예상됩니다.
케이엔더블유
반도체 소재로 사용되는 특수가스 f2, sf6가스를 제조하는 회사로 TSV 공정에서 식각을 할 때 해당 가스들이 필요로 합니다. 반도체 미세공정이 고차원화될수록 특수가스의 수요가 높아질 것으로 예상하고 있습니다.
케이씨텍
cmp(평탄화) 공정에 사용되는 연마소재를 생산하는 업체로 하이브리드 본딩의 수혜주로 부각 받고 있습니다.
윈팩
sk하이닉스에 d램 테스트의 50% 이상을 담당하고 있는 기업
오픈엣지 테크놀로지
고성능 AI 서버용 HBM 3급 이상의 인터페이스를 기술 개발 등의 IP 기술을 개발하는 업체
티에프이
초미세 기술 개발을 추진 HBM 을 테스트하기 위한 0.2 – 0.1 mm pitch 의 PCR 선행 개발하여 PKG 개발 로드맵에서 선제적 위치 확보